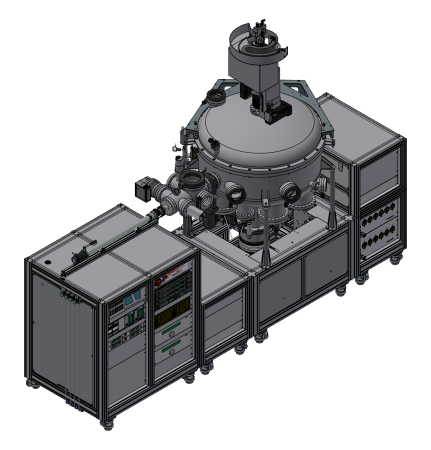
P363 – 3″ UHV sputter deposition MEET
Application
UHV sputter deposition system for thin film and multilayer deposition at 3″ substrates
Year of delivery
2012
Installation site
MEET, Münster, Germany
Design Features
- UHV magnetron sputter deposition system with combination of confocal and face to face sputter up configurations.
- Up to seven 2″ magnetrons in confocal configuration and up to three 4″ magnetrons in face to face configuration.
- 2″ magnetrons with manual in situ tilting.
- 4″ magnetrons with manual z translation stage.
- Fully motorized 3 axes sample manipulator with integrated motorized wedge shutter, DC Bias potential option and maximal sample temperature well above 800°C.
- Ion source for sample precleaning and mild etching.
- Integrated bake out system.
- Load lock chamber with lamp heating option.
Special Features
- Upto five 2″ magnetrons can be used in face to face configuration too.
- E-Beam source introduction possible.
- System is prepared for ion beam assisted deposition as well.
- Different sample sizes from 3″ wafer down to 10mm x 10mm samples can be handled (without the need of a sample adapter).
Outer Dimensions
Technical specifications and performance values
General
Sputtering chamber
Size
1000 mm diameter, about 800 mm height
Material
stainless steel
Load lock chamber
Size
150 mm diameter, about 250 mm height
Material
stainless steel
Vacuum
Sputtering chamber
Base pressure
< 5 *10-8 mbar
Pump down time
2 hours to < 2*10-6 mbar
Chamber pumping
Turbo pumping stage, chamber lid differentially pumped by dry foreline pump
Bake out
< 150°C
Load lock chamber
Base pressure
< 10-7 mbar
Pump down time
2 hours to < 10-6 mbar
Chamber pumping
Turbo pumping stage with dry foreline pump
Manipulator features
Sputtering chamber
Sample size
diameter max. 3″ substrate
Motion axes
3 motorized axes (manipulator arm rotation, z tranlsation and (continous) sample stage rotation)
Motorized wedge shutter (part of the manipulator head) with speed profile feature
Temperatures
Room temperature (not stabilized) up to > 850°C at sample
Special features
DC Sample bias is possible
Sample preparation features
Sputtering chamber
Plasma treatment
max. 10-3 mbar partly ionised gas mixture (using a griddless ion gun)
Gas mixture variable from pure argon up to pure oxygen
Ion beam etching /
sample precleaning
Wide range variation of ion source to sample distance
Wide range variation of ion energy and ion beam current
Load lock chamber
Thermal treatment
max. 350°C at sample (no temperature regulation)